5G時代下的FOPLP發(fā)展前景
2020/4/11 20:50:19 點擊:
先進封裝技術是高性能芯片的重要基礎之一。在過去幾年中,扇出型封裝是成長最為快速的先進封裝技術,其發(fā)展受到了業(yè)界的關注。扇出型封裝又分為扇出型晶圓封裝(FOWLP)以及扇出型板級封裝(FOPLP),扇出型晶圓封裝已經被許多消費電子產品所采用,扇出型板級封裝也即將進入到量產階段。
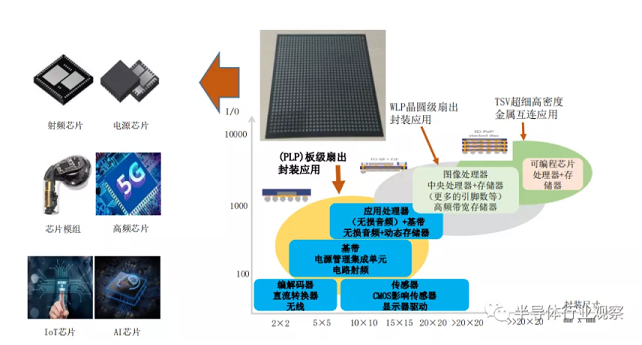
FOPLP被視為是延伸FOWLP、并可高整合度IC封裝的突破性技術。FOPLP可通過更大面積的方型載板來提高生產效率,成本比FOWLP更具競爭力,所以引起了市場的重視。
5G時代下的FOPLP市場情況
就最新的情況來看,5G和AI的到來,推動了手機、電腦、汽車以及物聯(lián)網等多個領域的發(fā)展。從手機方面來看,由于5G的發(fā)展促生了大量IC需求,在此期間,封裝技術也在5G的推動下發(fā)生了演進,越來越多的IC會采用扇出型封裝。透過扇出型封裝可將不同的IC整合在一起,從而提高整體的效率。
5G、AI和IoT的發(fā)展,也同樣推動了對扇出型板級封裝的需求。根據Yole的報告,扇出型板級封裝未來全球5年的年復合成長率可高達30%,2024年全球產值預期可達457百萬美元。此外,還有報告分析稱,如果FOPLP能夠進入到量產階段,就會使先進封裝的成本就會有所下降,而這將沖擊FOWLP的市場的份額。
原由FOWLP所占有的中低端市場,可能會首先轉向FOPLP。根據Manz資深銷售處長簡偉銓介紹,未來將會出現(xiàn)越來越多的異質整合IC,F(xiàn)OPLP技術可通過微細銅重布線路層(RDL) 連結的方式將這些芯片整合在單一封裝體中,從而實現(xiàn)更高密度重布線層(RDL)、更精細線寬/線距,達到與采用FOWLP封裝技術一樣的效果。在此基礎上,F(xiàn)OPLP具有顯著的成本及效能優(yōu)勢(FOWLP面積使用率較低
根據這種市場趨勢,也有一些廠商開始涉足FOPLP領域。根據麥姆斯咨詢去年發(fā)布的報告顯示,三星電機、力成科技、日月光(ASE/Deca)和納沛斯(Nepes)現(xiàn)正在利用現(xiàn)有設施和工藝能力,投資面扇出型板級封裝技術,以實現(xiàn)規(guī)模經濟生產。但就當前形勢來看,由于良率的限制,只有三星電機和力成能夠啟動量產。
簡偉銓強調,雖然FOPLP還未出現(xiàn)明顯的市場規(guī)模,但其成本效益相當誘人,面對未來可能持續(xù)擴大的下游IC市場。
發(fā)展FOPLP所面臨的挑戰(zhàn)與機會
在技術上,F(xiàn)OPLP要面臨著die漂移的問題、熱翹曲以及工藝平臺檢測等問題。除此之外,尺寸、制程等細節(jié)還尚未有共同的標準,整體FOPLP制程設備也有著非常高的定制化需求,因此,也為FOPLP的量產化制造了難度。這些都是FOPLP發(fā)展階段的挑戰(zhàn)。
FOPLP的發(fā)展為相關設備和材料帶來了新的機遇。針對FOPLP發(fā)展的需求,2017年Manz就宣布跨入半導體領域,為扇出型板級封裝提供各式相關生產設備解決方案。Manz結合自身30多年化學濕法制程設備的自主研發(fā)能力,掌握了先進封裝的關鍵黃光制程、電鍍等設備,能夠實現(xiàn)高密度重布線層等自身優(yōu)勢。其中,RDL是實現(xiàn)FOPLP的重要環(huán)節(jié):
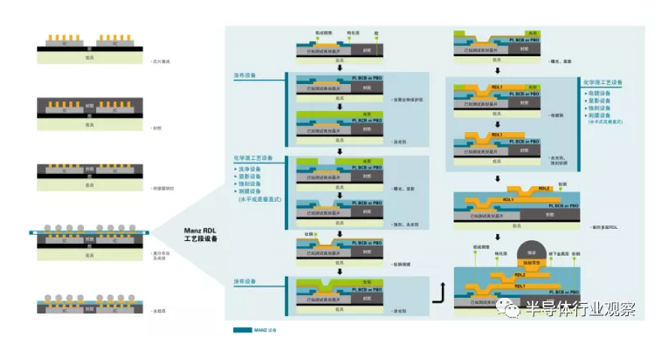
Manz掌握的RDL電鍍及銅蝕刻技術的獨特優(yōu)勢如下:
開創(chuàng)業(yè)界無治具垂直電鍍線,具備優(yōu)異的電鍍均勻性(>90%)及填孔能力(孔徑小于20um)
直電鍍銅線不需使用治具,減少維修成本
模塊化設計操作及維護具備便利性
適用于不同基板:FR4銅箔基板、鋼板及玻璃基板。其中玻璃基板的應用,可讓計劃跨入先進封裝領域的顯示器面板制造商,補足其對于在線性電鍍的工藝經驗
銅蝕刻線:Manz的裝備具有化學藥液和工藝的最佳結合,可確保完全去除銅種子層并有選擇性地進行銅蝕刻,銅蝕刻均勻性達93%.
以Manz 軟硬件的整合實力,可提供傳輸設備及CIM系統(tǒng)(Computer Integrated Manufacture-計算機制程整合)為進一步走向工業(yè)4.0
Manz與佛智芯合作,助力FOPLP發(fā)展
全球FOPLP都處于待發(fā)展的階段,我國本土的一些廠商也抓住了這一時機。為了促進國內FOPLP產線的落地,佛智芯與Manz進行了合作。
佛智芯是半導體創(chuàng)新中心依托中科院微電子所、廣東工業(yè)大學省部共建精密電子制造技術與裝備國家重點實驗室資源,并匯聚了華進半導體、安捷利、上達電子、豐江微電子在內的17個企業(yè)和高校科研機構共同成立的。佛智芯副總經理林挺宇博士介紹,佛智芯成立的目的是通過開發(fā)低成本大板級扇出型封裝新型工藝,推進國內首條板級扇出型封裝示范線建設,為板級扇出設備、工藝、材料改進及升級換代提供有力參考依據。
林挺宇表示:“由于FOPLP的尺寸和工藝標準尚未規(guī)范,通過佛智芯FOPLP示范線的建立,可以提前發(fā)現(xiàn)一些問題,從而能夠幫助相關企業(yè)更快地實現(xiàn)量產。”

根據啟信寶的消息顯示,華進半導體也是佛智芯的股東之一。據林挺宇介紹,華進半導體很早就參與到了FOPLP的發(fā)展中來。如果佛智芯FOPLP示范產線建成,將有利于國內相關封測廠商發(fā)展FOPLP業(yè)務。同時,林挺宇還表示,由于國內封測企業(yè)所經營的產品有所區(qū)別,所以在發(fā)展FOPLP業(yè)務時,這些企業(yè)之間暫時不會處于競爭的關系,而是一種互補的關系。
根據佛智芯發(fā)展FOPLP的計劃中看,在今年第3季度,所有的裝備將進入佛智芯的廠房,在第4季度所有的設備將能聯(lián)動起來。在尺寸上,公司計劃以300×300為突破點,在一兩年內切換到600×600上。林挺宇表示:“FOPLP首先要實現(xiàn)300×300封裝,達到與現(xiàn)在扇出型晶圓級封裝的同等水平。在這一過程中,佛智芯將在材料和設備上進行規(guī)范,以便能夠更好地向前發(fā)展。從效應角度上看,F(xiàn)OPLP在600×600板級上將凸顯優(yōu)勢。”同時,林挺宇也強調了,佛智芯旨在為能夠量產的企業(yè)提供total solution,按照計劃,佛智芯將在明年初能夠為產業(yè)提供相關解決方案。

根據佛智芯的發(fā)展規(guī)劃中看,設備對于FOPLP的發(fā)展至關重要。此次,佛智芯選擇了與Manz聯(lián)手同圖國內FOPLP產線的落地。佛智芯方面表示,Manz在FOPLP領域中積累了多年的經驗,在對接過程中,Manz能夠更加清楚FOPLP設備的痛點,從而能夠提供更加完善的解決方案。
據悉,Manz此次交付于佛智芯的裝備線,包括了為其工藝開發(fā)中心導入黃光制程設備。據介紹,該設備的導入完善了佛智芯在公共服務平臺中至關重要的設備驗證環(huán)節(jié),可以讓不同的客戶依據其制程及材料在裝備線得到產前打樣驗證,以此推動封裝領域中制造成本相對較低的扇出型板級封裝產業(yè)化解決方案。
根據此前的報道顯示,大板級扇出型封裝示范線預計在2019年下半年開始運作。同時為了使該條示范線得到更充分的利用,佛智芯還推出了多種運營模式以助力國內FOPLP的發(fā)展:
示范線將依托設備開放成果及封裝成套技術,為產業(yè)界提供封裝和測試服務;
將開發(fā)如汽車雷達、智能家居、消費電子等固定產品,并可為中小企業(yè)直接提供此類產品的小規(guī)模封裝代工量產服務;
將提供封測材料的評估驗證服務,包括工藝評估、可靠性評估以及小批量量產評估等服務。
關鍵字:FOPLP 5G 扇出形封裝
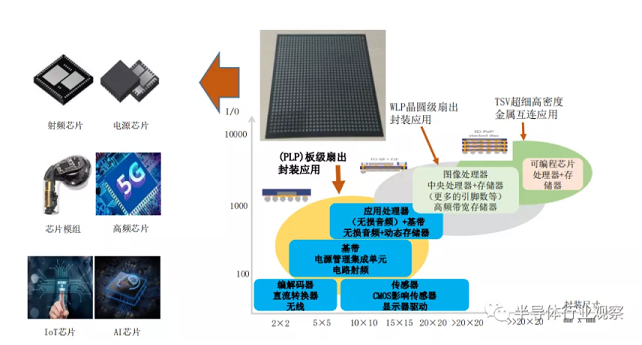
FOPLP被視為是延伸FOWLP、并可高整合度IC封裝的突破性技術。FOPLP可通過更大面積的方型載板來提高生產效率,成本比FOWLP更具競爭力,所以引起了市場的重視。
5G時代下的FOPLP市場情況
就最新的情況來看,5G和AI的到來,推動了手機、電腦、汽車以及物聯(lián)網等多個領域的發(fā)展。從手機方面來看,由于5G的發(fā)展促生了大量IC需求,在此期間,封裝技術也在5G的推動下發(fā)生了演進,越來越多的IC會采用扇出型封裝。透過扇出型封裝可將不同的IC整合在一起,從而提高整體的效率。
5G、AI和IoT的發(fā)展,也同樣推動了對扇出型板級封裝的需求。根據Yole的報告,扇出型板級封裝未來全球5年的年復合成長率可高達30%,2024年全球產值預期可達457百萬美元。此外,還有報告分析稱,如果FOPLP能夠進入到量產階段,就會使先進封裝的成本就會有所下降,而這將沖擊FOWLP的市場的份額。
原由FOWLP所占有的中低端市場,可能會首先轉向FOPLP。根據Manz資深銷售處長簡偉銓介紹,未來將會出現(xiàn)越來越多的異質整合IC,F(xiàn)OPLP技術可通過微細銅重布線路層(RDL) 連結的方式將這些芯片整合在單一封裝體中,從而實現(xiàn)更高密度重布線層(RDL)、更精細線寬/線距,達到與采用FOWLP封裝技術一樣的效果。在此基礎上,F(xiàn)OPLP具有顯著的成本及效能優(yōu)勢(FOWLP面積使用率較低
根據這種市場趨勢,也有一些廠商開始涉足FOPLP領域。根據麥姆斯咨詢去年發(fā)布的報告顯示,三星電機、力成科技、日月光(ASE/Deca)和納沛斯(Nepes)現(xiàn)正在利用現(xiàn)有設施和工藝能力,投資面扇出型板級封裝技術,以實現(xiàn)規(guī)模經濟生產。但就當前形勢來看,由于良率的限制,只有三星電機和力成能夠啟動量產。
簡偉銓強調,雖然FOPLP還未出現(xiàn)明顯的市場規(guī)模,但其成本效益相當誘人,面對未來可能持續(xù)擴大的下游IC市場。
發(fā)展FOPLP所面臨的挑戰(zhàn)與機會
在技術上,F(xiàn)OPLP要面臨著die漂移的問題、熱翹曲以及工藝平臺檢測等問題。除此之外,尺寸、制程等細節(jié)還尚未有共同的標準,整體FOPLP制程設備也有著非常高的定制化需求,因此,也為FOPLP的量產化制造了難度。這些都是FOPLP發(fā)展階段的挑戰(zhàn)。
FOPLP的發(fā)展為相關設備和材料帶來了新的機遇。針對FOPLP發(fā)展的需求,2017年Manz就宣布跨入半導體領域,為扇出型板級封裝提供各式相關生產設備解決方案。Manz結合自身30多年化學濕法制程設備的自主研發(fā)能力,掌握了先進封裝的關鍵黃光制程、電鍍等設備,能夠實現(xiàn)高密度重布線層等自身優(yōu)勢。其中,RDL是實現(xiàn)FOPLP的重要環(huán)節(jié):
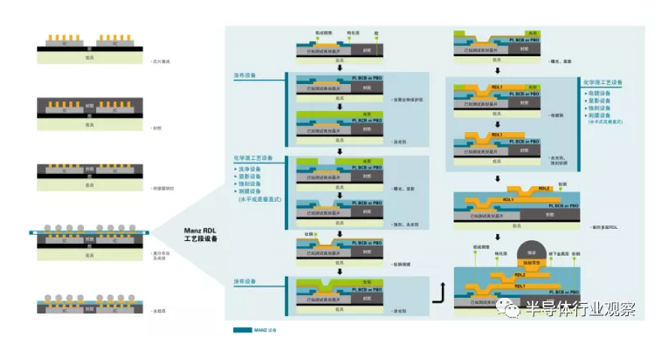
Manz掌握的RDL電鍍及銅蝕刻技術的獨特優(yōu)勢如下:
開創(chuàng)業(yè)界無治具垂直電鍍線,具備優(yōu)異的電鍍均勻性(>90%)及填孔能力(孔徑小于20um)
直電鍍銅線不需使用治具,減少維修成本
模塊化設計操作及維護具備便利性
適用于不同基板:FR4銅箔基板、鋼板及玻璃基板。其中玻璃基板的應用,可讓計劃跨入先進封裝領域的顯示器面板制造商,補足其對于在線性電鍍的工藝經驗
銅蝕刻線:Manz的裝備具有化學藥液和工藝的最佳結合,可確保完全去除銅種子層并有選擇性地進行銅蝕刻,銅蝕刻均勻性達93%.
以Manz 軟硬件的整合實力,可提供傳輸設備及CIM系統(tǒng)(Computer Integrated Manufacture-計算機制程整合)為進一步走向工業(yè)4.0
Manz與佛智芯合作,助力FOPLP發(fā)展
全球FOPLP都處于待發(fā)展的階段,我國本土的一些廠商也抓住了這一時機。為了促進國內FOPLP產線的落地,佛智芯與Manz進行了合作。
佛智芯是半導體創(chuàng)新中心依托中科院微電子所、廣東工業(yè)大學省部共建精密電子制造技術與裝備國家重點實驗室資源,并匯聚了華進半導體、安捷利、上達電子、豐江微電子在內的17個企業(yè)和高校科研機構共同成立的。佛智芯副總經理林挺宇博士介紹,佛智芯成立的目的是通過開發(fā)低成本大板級扇出型封裝新型工藝,推進國內首條板級扇出型封裝示范線建設,為板級扇出設備、工藝、材料改進及升級換代提供有力參考依據。
林挺宇表示:“由于FOPLP的尺寸和工藝標準尚未規(guī)范,通過佛智芯FOPLP示范線的建立,可以提前發(fā)現(xiàn)一些問題,從而能夠幫助相關企業(yè)更快地實現(xiàn)量產。”

根據啟信寶的消息顯示,華進半導體也是佛智芯的股東之一。據林挺宇介紹,華進半導體很早就參與到了FOPLP的發(fā)展中來。如果佛智芯FOPLP示范產線建成,將有利于國內相關封測廠商發(fā)展FOPLP業(yè)務。同時,林挺宇還表示,由于國內封測企業(yè)所經營的產品有所區(qū)別,所以在發(fā)展FOPLP業(yè)務時,這些企業(yè)之間暫時不會處于競爭的關系,而是一種互補的關系。
根據佛智芯發(fā)展FOPLP的計劃中看,在今年第3季度,所有的裝備將進入佛智芯的廠房,在第4季度所有的設備將能聯(lián)動起來。在尺寸上,公司計劃以300×300為突破點,在一兩年內切換到600×600上。林挺宇表示:“FOPLP首先要實現(xiàn)300×300封裝,達到與現(xiàn)在扇出型晶圓級封裝的同等水平。在這一過程中,佛智芯將在材料和設備上進行規(guī)范,以便能夠更好地向前發(fā)展。從效應角度上看,F(xiàn)OPLP在600×600板級上將凸顯優(yōu)勢。”同時,林挺宇也強調了,佛智芯旨在為能夠量產的企業(yè)提供total solution,按照計劃,佛智芯將在明年初能夠為產業(yè)提供相關解決方案。

根據佛智芯的發(fā)展規(guī)劃中看,設備對于FOPLP的發(fā)展至關重要。此次,佛智芯選擇了與Manz聯(lián)手同圖國內FOPLP產線的落地。佛智芯方面表示,Manz在FOPLP領域中積累了多年的經驗,在對接過程中,Manz能夠更加清楚FOPLP設備的痛點,從而能夠提供更加完善的解決方案。
據悉,Manz此次交付于佛智芯的裝備線,包括了為其工藝開發(fā)中心導入黃光制程設備。據介紹,該設備的導入完善了佛智芯在公共服務平臺中至關重要的設備驗證環(huán)節(jié),可以讓不同的客戶依據其制程及材料在裝備線得到產前打樣驗證,以此推動封裝領域中制造成本相對較低的扇出型板級封裝產業(yè)化解決方案。
根據此前的報道顯示,大板級扇出型封裝示范線預計在2019年下半年開始運作。同時為了使該條示范線得到更充分的利用,佛智芯還推出了多種運營模式以助力國內FOPLP的發(fā)展:
示范線將依托設備開放成果及封裝成套技術,為產業(yè)界提供封裝和測試服務;
將開發(fā)如汽車雷達、智能家居、消費電子等固定產品,并可為中小企業(yè)直接提供此類產品的小規(guī)模封裝代工量產服務;
將提供封測材料的評估驗證服務,包括工藝評估、可靠性評估以及小批量量產評估等服務。
關鍵字:FOPLP 5G 扇出形封裝
- 上一篇:按摩筋膜槍三相無刷電機馬達驅動芯片與MOS管如何選型 推薦用 2020/4/11
- 下一篇:直流電機驅動芯片GC8837與DRV8837 2020/4/10

