3D封裝的芯片內部長啥樣?英特爾最新款CPU拆解照片曝光
2020-3-18 21:37:39??????點擊:
[導讀]Lakefield是英特爾基于Foveros技術的首款3D堆疊芯片。裸片(Die)面積為82平方mm。
Lakefield是英特爾基于Foveros技術的首款3D堆疊芯片。裸片(Die)面積為82平方mm。
最近國外媒體放出了該芯片的裸片(Die)拆解圖片:
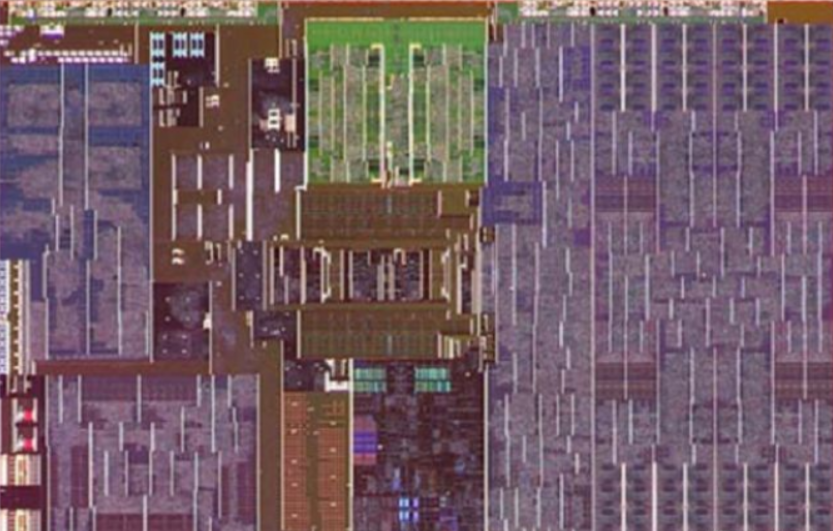
根據圖像信息,Lakefield芯片的面積為82平方mm,與雙核14nm Broadwell-Y芯片一樣大。中間的綠色區域是Tremont群集,面積為5.1平方毫米,而其底部中央的黑色區域則是Sunny Cove核心。右側的GPU占據了約40%的芯片面積。據去年英特爾對Lakefield、Foveros及其混合架構的介紹,總封裝尺寸僅為為12mm x 12mm。如此小的封裝尺寸歸因于采用英特爾Foveros技術的3D堆疊:封裝內采用的是22FFL的基板芯片,該芯片通過Foveros有源插入技術與10nm計算芯片連接。計算芯片包含一個Sunny Cove內核和四個Atom Tremont corex。芯片上方還有采用PoP(層疊封裝)封裝的DRAM。
Lakefield是英特爾基于Foveros技術的首款3D堆疊芯片。裸片(Die)面積為82平方mm。
最近國外媒體放出了該芯片的裸片(Die)拆解圖片:
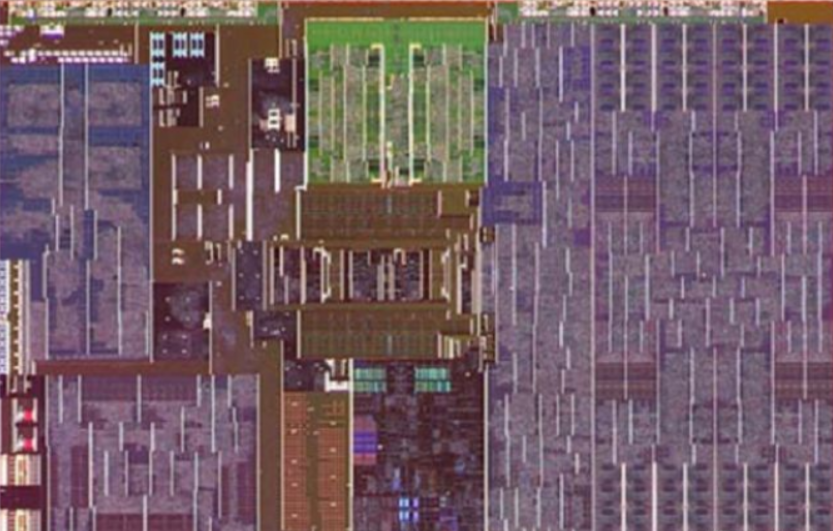
根據圖像信息,Lakefield芯片的面積為82平方mm,與雙核14nm Broadwell-Y芯片一樣大。中間的綠色區域是Tremont群集,面積為5.1平方毫米,而其底部中央的黑色區域則是Sunny Cove核心。右側的GPU占據了約40%的芯片面積。據去年英特爾對Lakefield、Foveros及其混合架構的介紹,總封裝尺寸僅為為12mm x 12mm。如此小的封裝尺寸歸因于采用英特爾Foveros技術的3D堆疊:封裝內采用的是22FFL的基板芯片,該芯片通過Foveros有源插入技術與10nm計算芯片連接。計算芯片包含一個Sunny Cove內核和四個Atom Tremont corex。芯片上方還有采用PoP(層疊封裝)封裝的DRAM。
- 上一篇:2020全球可穿戴設備市場增幅將從去年的89%降至9.4% 2020/3/18
- 下一篇:三星電子預計今年全球芯片需求仍將增長 2020/3/18

